アンダーフィルは、モジュールの主要コンポーネントの周囲の下に塗布されるポリマーまたは液体エポキシであり、はんだ接合を強化し、衝撃、振動応力、重力加速度に対する製品の耐性を強化します。
アンダーフィルを選ぶ理由は?
輸送、自動車、産業用途などの過酷な環境では、BGA(Ball Grid Array:ボールグリッドアレイ)は機械的衝撃および基板の屈曲テストに対応するのが困難な表面実装コンポーネントです。これらのパッケージは、落下、曲げ、ねじれのテスト、または衝撃や振動のテストに耐えるようには設計されていません。

どのように機能しますか?
アンダーフィルは、振動に対する耐性を高め、熱応力による損傷を減らすために、BGAコンポーネントと回路基板の間に強力な機械的結合を実現します。
1.フラックスディスペンシング:チップと基板の間のギャップに、制御された量のフラックス材料をディスペンスします。
2.チップの配置:チップを基板に合わせます。
3.はんだリフロー:アセンブリをリフローはんだオーブンに通します。
4.フラックスクレンジング:残ったフラックスの残留物を取り除きます。
5.アンダーフィルディスペンシング:アンダーフィルを基板にディスペンスします。
6.アンダーフィル硬化:オーブンでアンダーフィルを熱硬化させます。

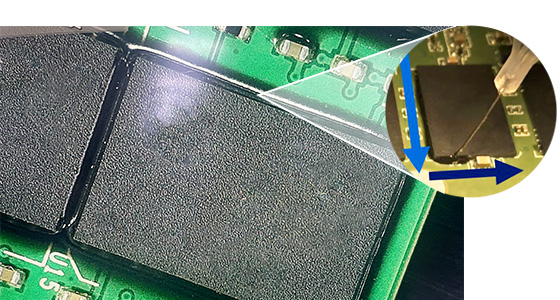
SMARTのアンダーフィル技術対応DRAMソリューション
SMART Modularのメモリモジュールは、産業用温度対応とアンダーフィル技術を備え、ミッションクリティカルなアプリケーションに信頼性の高いソリューションを提供します。信頼性、性能、環境耐性を強化することで、さまざまな業界における先進的な高性能コンピューティングシステムの開発を支援します。










